関係者によると、サムスン電子とSKハイニックスは2026年以降に積層型モバイルメモリを商品化する予定
9月3日の当サイトのニュースによると、韓国メディアetnewsは昨日(現地時間)、サムスン電子とSKハイニックスの「HBMのような」積層構造モバイルメモリ製品が2026年以降に商品化されると報じた。
関係者によると、韓国のメモリ大手 2 社は、スタック型モバイルメモリを将来の重要な収益源と考えており、「HBM のようなメモリ」をスマートフォン、タブレット、ラップトップに拡張して、エンドユーザーのサポートを提供する予定であるとのことです。サイド AI がモチベーションを提供します。
このサイトの以前のレポートによると、Samsung Electronics の製品は LP Wide I/O メモリと呼ばれ、SK Hynix はこの技術を VFO と呼んでいます。両社は、ファンアウト パッケージングと垂直チャネルを組み合わせるという、ほぼ同じ技術的手法を採用しました。
Samsung Electronics の LP Wide I/O メモリは、既存の LPDDR メモリの 8 倍である 512 ビットのビット幅を持ち、8 倍の I/O 密度と 2.6 倍の I/O 帯域幅を備えています。従来のワイヤボンディングと比較して。このメモリは2025年第1四半期に技術的に準備が整い、2025年後半から2026年半ばまでに量産準備が整う予定だ。

そして、SK Hynix の VFO 技術検証サンプルは、配線長を従来のメモリの 1/4 以下に短縮し、エネルギー効率を 4.9% 向上させました。このソリューションにより、熱放散が 1.4% 増加しますが、パッケージの厚さは 27% 減少します。

報告書は、これらの積層型モバイルメモリをどのようにプロセッサと統合するかについてはまだ結論が出ていないことを指摘しており、議論中のソリューションにはHBMやHBMと同様の2.5Dパッケージングが含まれている。 3D垂直スタッキング。
半導体パッケージング業界の関係者は、モバイルプロセッサの設計と配置が積層型モバイルメモリの構成と接続方法に影響を与えると述べ、これは新世代のモバイルメモリが仕様に応じてカスタマイズされ、供給されることを意味するという。パートナーのニーズに応え、モバイル DRAM 市場の状況を完全に変えます。
以上が関係者によると、サムスン電子とSKハイニックスは2026年以降に積層型モバイルメモリを商品化する予定の詳細内容です。詳細については、PHP 中国語 Web サイトの他の関連記事を参照してください。

ホットAIツール

Undress AI Tool
脱衣画像を無料で

Undresser.AI Undress
リアルなヌード写真を作成する AI 搭載アプリ

AI Clothes Remover
写真から衣服を削除するオンライン AI ツール。

Stock Market GPT
AIを活用した投資調査により賢明な意思決定を実現

人気の記事

ホットツール

メモ帳++7.3.1
使いやすく無料のコードエディター

SublimeText3 中国語版
中国語版、とても使いやすい

ゼンドスタジオ 13.0.1
強力な PHP 統合開発環境

ドリームウィーバー CS6
ビジュアル Web 開発ツール

SublimeText3 Mac版
神レベルのコード編集ソフト(SublimeText3)
 大規模なメモリの最適化。コンピュータが 16g/32g のメモリ速度にアップグレードしても変化がない場合はどうすればよいですか?
Jun 18, 2024 pm 06:51 PM
大規模なメモリの最適化。コンピュータが 16g/32g のメモリ速度にアップグレードしても変化がない場合はどうすればよいですか?
Jun 18, 2024 pm 06:51 PM
機械式ハード ドライブまたは SATA ソリッド ステート ドライブの場合、NVME ハード ドライブの場合は、ソフトウェアの実行速度の向上を感じられない場合があります。 1. レジストリをデスクトップにインポートし、新しいテキスト ドキュメントを作成し、次の内容をコピーして貼り付け、1.reg として保存し、右クリックしてマージしてコンピュータを再起動します。 WindowsRegistryEditorVersion5.00[HKEY_LOCAL_MACHINE\SYSTEM\CurrentControlSet\Control\SessionManager\MemoryManagement]"DisablePagingExecutive"=d
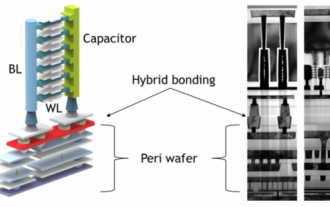 関係者によると、SKハイニックスの5層積層3D DRAMメモリの歩留まりは56.1%に達した
Jun 24, 2024 pm 01:52 PM
関係者によると、SKハイニックスの5層積層3D DRAMメモリの歩留まりは56.1%に達した
Jun 24, 2024 pm 01:52 PM
6月24日の当サイトのニュースによると、韓国メディアBusinessKoreaは、SKハイニックスが6月16日から20日まで米国ハワイで開催されたVLSI 2024サミットで3D DRAM技術に関する最新の研究論文を発表したと業界関係者が明らかにしたと報じた。この論文でSK Hynixは、5層積層型3D DRAMのメモリ歩留まりが56.1%に達し、実験で使用した3D DRAMは現行の2D DRAMと同様の特性を示したと報告している。報告書によると、メモリセルを水平に配置する従来のDRAMとは異なり、3D DRAMはセルを垂直に積み重ねて同じ空間内でより高い密度を実現します。しかし、SKハイニックスは
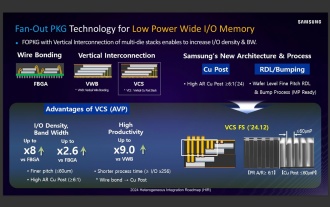 関係者によると、サムスン電子とSKハイニックスは2026年以降に積層型モバイルメモリを商品化する予定
Sep 03, 2024 pm 02:15 PM
関係者によると、サムスン電子とSKハイニックスは2026年以降に積層型モバイルメモリを商品化する予定
Sep 03, 2024 pm 02:15 PM
9月3日の当ウェブサイトのニュースによると、韓国メディアetnewsは昨日(現地時間)、サムスン電子とSKハイニックスの「HBM類似」積層構造モバイルメモリ製品が2026年以降に商品化されると報じた。関係者によると、韓国のメモリ大手2社はスタック型モバイルメモリを将来の重要な収益源と考えており、エンドサイドAIに電力を供給するために「HBMのようなメモリ」をスマートフォン、タブレット、ラップトップに拡張する計画だという。このサイトの以前のレポートによると、Samsung Electronics の製品は LPwide I/O メモリと呼ばれ、SK Hynix はこのテクノロジーを VFO と呼んでいます。両社はほぼ同じ技術的ルート、つまりファンアウト パッケージングと垂直チャネルを組み合わせたものを使用しました。 Samsung Electronics の LPwide I/O メモリのビット幅は 512
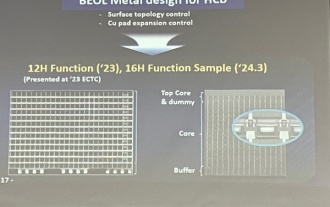 サムスン、HBM4メモリでの普及が期待される16層ハイブリッドボンディング積層プロセス技術検証完了を発表
Apr 07, 2024 pm 09:19 PM
サムスン、HBM4メモリでの普及が期待される16層ハイブリッドボンディング積層プロセス技術検証完了を発表
Apr 07, 2024 pm 09:19 PM
報告書によると、サムスン電子幹部のキム大宇氏は、2024年の韓国マイクロエレクトロニクス・パッケージング協会年次総会で、サムスン電子は16層ハイブリッドボンディングHBMメモリ技術の検証を完了すると述べた。この技術は技術検証を通過したと報告されています。同報告書では、今回の技術検証が今後数年間のメモリ市場発展の基礎を築くとも述べている。 DaeWooKim氏は、「サムスン電子がハイブリッドボンディング技術に基づいて16層積層HBM3メモリの製造に成功した。メモリサンプルは正常に動作する。将来的には、16層積層ハイブリッドボンディング技術がHBM4メモリの量産に使用されるだろう」と述べた。 ▲画像出典 TheElec、以下同 ハイブリッドボンディングは、既存のボンディングプロセスと比較して、DRAMメモリ層間にバンプを追加する必要がなく、上下層の銅と銅を直接接続する。
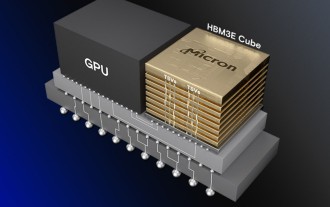 マイクロン:HBMメモリはウェーハ量の3倍を消費し、生産能力は基本的に来年に予約される
Mar 22, 2024 pm 08:16 PM
マイクロン:HBMメモリはウェーハ量の3倍を消費し、生産能力は基本的に来年に予約される
Mar 22, 2024 pm 08:16 PM
当サイトは3月21日、マイクロンが四半期財務報告書の発表後に電話会議を開催したと報じた。 Micron CEOのSanjay Mehrotra氏はカンファレンスで、従来のメモリと比較してHBMは大幅に多くのウエハを消費すると述べた。マイクロンは、同じノードで同じ容量を生産する場合、現在最も先進的なHBM3Eメモリは標準的なDDR5の3倍のウエハを消費し、性能の向上とパッケージングの複雑さの増大により、将来的にはHBM4のこの比率がさらに増加すると予想されていると述べました。 。このサイトの以前のレポートを参照すると、この高い比率は HBM の歩留まりの低さによる部分もあります。 HBM メモリは、多層の DRAM メモリ TSV 接続でスタックされており、1 つの層に問題があると、全体の層に問題が発生することを意味します。
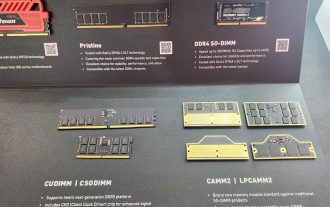 Kingbang が新しい DDR5 8600 メモリを発売、CAMM2、LPCAMM2、および通常のモデルから選択可能
Jun 08, 2024 pm 01:35 PM
Kingbang が新しい DDR5 8600 メモリを発売、CAMM2、LPCAMM2、および通常のモデルから選択可能
Jun 08, 2024 pm 01:35 PM
6 月 7 日のこのサイトのニュースによると、GEIL は 2024 台北国際コンピューター ショーで最新の DDR5 ソリューションを発表し、SO-DIMM、CUDIMM、CSODIMM、CAMM2、および LPCAMM2 バージョンから選択できるように提供しました。 ▲画像出典:Wccftech 写真に示すように、Jinbang が展示した CAMM2/LPCAMM2 メモリは非常にコンパクトな設計を採用しており、最大 128GB の容量と最大 8533MT/s の速度を実現できる製品もあります。 AMDAM5 プラットフォームで安定しており、補助冷却なしで 9000MT/s までオーバークロックされます。レポートによると、Jinbang の 2024 Polaris RGBDDR5 シリーズ メモリは最大 8400 のメモリを提供できます。
 Lexar が Ares Wings of War DDR5 7600 16GB x2 メモリ キットを発売: Hynix A-die パーティクル、1,299 人民元
May 07, 2024 am 08:13 AM
Lexar が Ares Wings of War DDR5 7600 16GB x2 メモリ キットを発売: Hynix A-die パーティクル、1,299 人民元
May 07, 2024 am 08:13 AM
5月6日のこのウェブサイトのニュースによると、LexarはAres Wings of WarシリーズのDDR57600CL36オーバークロックメモリを発売しました。16GBx2セットは50元のデポジットで5月7日0:00に予約販売されます。 1,299元。 Lexar Wings of War メモリは、Hynix A-die メモリ チップを使用し、Intel XMP3.0 をサポートし、次の 2 つのオーバークロック プリセットを提供します: 7600MT/s: CL36-46-46-961.4V8000MT/s: CL38-48-49 -1001.45V放熱に関しては、このメモリ セットには厚さ 1.8 mm の全アルミニウム放熱ベストが装備されており、PMIC 独自の熱伝導性シリコン グリース パッドが装備されています。メモリは 8 つの高輝度 LED ビーズを使用し、13 の RGB 照明モードをサポートします。
 Hynix は UFS 4.1 フラッシュ メモリを初めて実証しました: V9 TLC NAND 粒子に基づく
Aug 09, 2024 pm 03:33 PM
Hynix は UFS 4.1 フラッシュ メモリを初めて実証しました: V9 TLC NAND 粒子に基づく
Aug 09, 2024 pm 03:33 PM
8月9日のニュースによると、SK HynixはFMS2024サミットで、仕様がまだ正式にリリースされていないUFS4.1ユニバーサルフラッシュメモリを含む最新のストレージ製品をデモした。 JEDEC Solid State Technology Associationの公式Webサイトによると、現在発表されている最新のUFS仕様は2022年8月のUFS4.0です。理論上のインターフェース速度は46.4Gbpsと高速で、UFS4.1ではさらに伝送速度が向上すると予想されています。レート。 1. Hynix は、321 層 V91TbTLCNAND フラッシュ メモリをベースとした 512GB および 1TBUFS4.1 の汎用フラッシュ メモリ製品をデモしました。 SK Hynixは3.2GbpsV92TbQLC粒子と3.6GbpsV9H1TbTLC粒子も展示した。 Hynix が V7 ベースを披露






